کندوپاش بایاس
کندوپاش بایاس یا بایاس کردن زیرلایه، شامل اِعمال ولتاژ الکتریکی به زیرلایه در حین لایهنشانی کندوپاشی است که بمباران یونی زیرلایه و پوشش را در طول فرآیند لایهنشانی افزایش میدهد. هدف اصلی کندوپاش بایاس زیرلایه، به حداقل رساندن آلودگی لایه توسط اتمهای گاز فرآیند است و به تولید لایههای متراکمتر با مقاومت الکتریکی کمتر در مقایسه با لایههایی که بدون بایاس کردن زیرلایه تشکیل میشوند، کمک میکند.

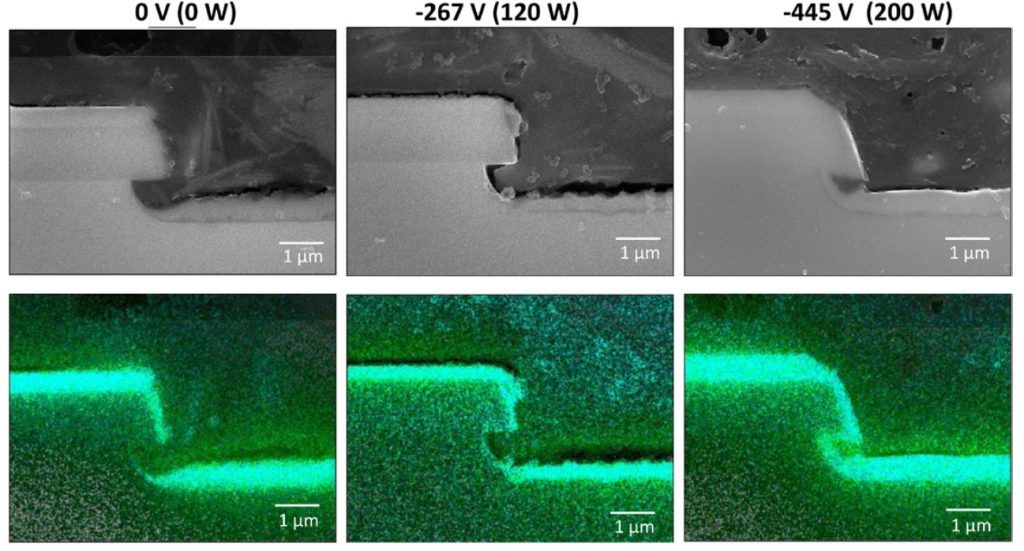
کندوپاش با بایاس زیرلایه چگونه کار میکند؟
در طول فرآیند کندوپاش، سطح هدف کندوپاشی توسط یونهای مثبت تولید شده در پلاسمای گاز فرآیند بمباران میشود. شدت بمباران یونی زیرلایه را میتوان با تنظیم ولتاژ اعمال شده به آن کنترل کرد و بدین ترتیب میتوان جهت و انرژی جنبشی ذرات ورودی به سطح زیرلایه را تغییر داد، در نتیجه عمق نفوذ ذرات لایهنشانی شده را کنترل کرده و به ساختارهایی با نسبت ابعاد بالاتر دست یافت. بایاس زیرلایه همچنین به افزایش سرعت لایهنشانی کمک میکند.
اعمال ولتاژ بایاس منفی به زیرلایه باعث میشود یونهای مثبت، سطح زیرلایه را بمباران کنند و باعث توزیع زاویهای و چگالی یکنواختتر لایه نازک شوند. اعمال ولتاژ بایاس مثبت به زیرلایه در ایجاد یک لایه پیوند اکسیدی روی آن کمک میکند و از این رو چسبندگی لایه بعدی به آن را بهبود میبخشد.
کاربردهای کندوپاش بایاس
اعمال ولتاژ بایاس منفی به زیرلایه منجر به افزایش انرژی یون و بهبود برخی از ویژگیهای پوششدهی میشود که به دلیل برخی از معایب این روش، مانند ایجاد تنش بالا، باید بهینه شوند.
بایاس زیرلایه همچنین موجب تمیز کردن یونی سطح زیرلایه قبل از فرآیند لایهنشانی توسط برخورد یونهای پرانرژی به آن میشود. علاوه بر این، فوتونهای پرانرژی فرابنفش تولید شده در پلاسما به پدیده بایاس فوتونی کمک میکنند و ناخالصیها را از سطح زیرلایه محو میکنند.
بایاس زیرلایه در اسپاترینگ بایاس میتواند خواص مکانیکی پوشش و چسبندگی به زیرلایه را بهبود بخشد، و چگالی جرمی بالاتر، بلورینگی بهتر و زبری سطح بالاتر را ایجاد نماید. همچنین موجب بهبود خواص الکتریکی لایه مانند کاهش مقاومت الکتریکی میشود.
بایاس کردن زیرلایه در کاربردهای مختلفی از جمله موارد زیر موثر است:
- نیمهرساناها
- لایههای نازک مغناطیسی
- لایههای نازک ابررسانا
- رسوب لایههای نازک تانتالوم، نیوبیوم، تنگستن و آلومینیوم برای میکروالکترونیک
علاوه بر این، کندوپاش بایاس، توزیع مجدد اتمهای کندوپاش شده روی سطح زیرلایه را امکانپذیر میکند و منجر به پوششی صاف و یکدست، حتی روی ساختارهای سهبعدی میشود که در پوششدهی لایههای نازک رسانا روی نمونههای میکروسکوپ الکترونی برای دستیابی به تصاویر با وضوح بالا، مفید است.
لایهنشانهای ما و کندوپاش بایاس
کندوپاش بایاس با اعمال ولتاژ به زیرلایه در طول فرآیند کندوپاش انجام میشود و تکنیکی برای اصلاح ویژگیهای لایه نازک کندوپاش شده، شامل خواص مکانیکی، مقاومت الکتریکی و چسبندگی به زیرلایه است. لایهنشانهای کندوپاشی شرکت پوششهای نانوساختار با قابلیت انتخابی بایاس زیرلایه برای بهبود روش پوششدهی و ایجاد لایههای نازک با ساختارهای دلخواه را ارائه میدهد.
شرکت پوششهای نانوساختار سیستمهای تک کاتدی و چند کاتدی، مانند DST1-300 و DST3، را با گزینه بایاس زیرلایه، ارائه میدهد که میتواند در پروژههای تحقیقاتی پیشرفته برای تولید ساختارهای لایه نازک جدید مورد استفاده قرار گیرند.
برخی سیستمهای خلاء پوششهای نانوساختار
منابع
- Seeman, James M. “Bias sputtering: its techniques and applications.” Vacuum 17.3 (1967): 129-137.
- Maissel, L. I., and P. M. Schaible. “Thin films deposited by bias sputtering.” Journal of Applied Physics 36.1 (1965): 237-242.
- Lee, Hwan-Chul, Jai-Young Lee, and Hyo-Jun Ahn. “Effect of the substrate bias voltage on the crystallographic orientation of reactively sputtered AlN thin films.” Thin Solid Films 251.2 (1994): 136-140.
- Ouis, Abousoufiane, and Michel Cailler. “Effects of substrate bias voltage on adhesion of DC magnetron-sputtered copper films on E24 carbon steel: investigations by Auger electron spectroscopy.” Journal of adhesion science and technology 27.21 (2013): 2367-2386.
- Vassallo, Espedito, et al. “Effect of Negative Substrate Bias Voltage and Pressure on the Structure and Properties of Tungsten Films Deposited by Magnetron Sputtering Technique.” Coatings 15.3 (2025): 319.
- Jang, Gil Su, Seon Mi Ahn, and Nong-Moon Hwang. “Effects of sputtering power, working pressure, and electric bias on the deposition behavior of Ag films during DC magnetron sputtering considering the generation of charged flux.” Electronic Materials Letters 18.1 (2022): 57-68.
- Brown, Hayley L., et al. “The impact of substrate bias on a remote plasma sputter coating process for conformal coverage of trenches and 3D structures.” Journal of Physics D: Applied Physics 48.33 (2015): 335303.












